Компания Intel сравнила свое интерконнект-решение EMIB с традиционными технологиями 2.5D и продемонстрировала его превосходство в проектировании передовых упакованных чипов.
Intel Демонстрирует, Как Технология EMIB Позволяет Создавать Лучшие и Более Масштабируемые Решения для Передовой Упаковки по Сравнению с Традиционными Подходами 2.5D
Технология EMIB от Intel нашла применение в различных чипах, преимущественно собственного производства компании. Это интерконнект-решение использовалось в линейках Ponte Vecchio, Sapphire Rapids, Granite Rapids, Sierra Forest, а также в предстоящей Clearwater Forest.
Intel уже продемонстрировала планы по масштабированию возможностей передовой упаковки для чипов следующего поколения, предназначенных как для собственного использования, так и для клиентов её литейного бизнеса. Компания акцентировала внимание на массивных корпусах, использующих EMIB и ряд других собственных технологий упаковки. Все они представляют собой передовые чиповые решения для дата-центров, объединяющие множество чиплетов, соединенных через интерконнект EMIB.

Конкурирующие технологии передовой упаковки, например, от TSMC, основаны на 2.5D и 3D-упаковке. Вместо небольшого соединительного моста, как в EMIB, 2.5D-упаковка TSMC использует кремниевый интерпозер между кристаллами (чиплетами) и подложкой корпуса. Соединение обеспечивается серией проводников, проходящих внутри кремния, известных как TSV (Through Silicon Vias). Эти проводники служат для связи нескольких кристаллов.

По мнению Intel, технология 2.5D-упаковки имеет ряд недостатков. Во-первых, вы платите дополнительно за кремний, необходимый лишь для размещения проводников, и чем больше чип, тем дороже становится упаковочное решение из-за усложнения проектирования и снижения выхода годных изделий вследствие использования TSV.
Эта технология также накладывает ограничения на максимальный размер, достигаемый при использовании маршрута 2.5D. Это приводит к недостаточной гибкости в комбинациях чиплетов, позволяя смешивать и сочетать различные вычислительные и мемори-кристаллы.

В случае с EMIB необходимость в кремнии между кристаллом и корпусом отпадает. Эти небольшие мосты встраиваются в подложку и могут быть размещены там, где требуется соединение двух кристаллов. Хотя EMIB существует уже некоторое время, это хорошее напоминание о самой технологии. EMIB имеет два основных варианта, которые описаны ниже:
EMIB 2.5D
Embedded Multi-die Interconnect Bridge 2.5D (Встроенный многокристальный соединительный мост 2.5D).
- Эффективный и экономичный способ соединения нескольких сложных кристаллов.
- 2.5D-упаковка для логических блоков и логики с памятью высокой пропускной способности (HBM).
- EMIB-M включает MIM-конденсаторы в мосте. EMIB-T добавляет TSV к мосту.
- Кремниевый мост, встроенный в подложку корпуса для соединения от края до края.
- EMIB-T упрощает интеграцию IP из других проектных решений по упаковке.
- Упрощение цепочки поставок и процесса сборки.
- Проверенное производство: в массовом производстве с 2017 года с использованием кремния Intel и сторонних производителей.
EMIB 3.5D
Embedded Multi-die Interconnect Bridge 3.5D и Foveros в одном корпусе.
- Обеспечивает гибкие гетерогенные системы с широким набором кристаллов.
- Хорошо подходит для приложений, где требуется объединить несколько 3D-стеков в одном корпусе.
- Intel Data Center GPU Max Series SoC: использует EMIB 3.5D для создания самого сложного гетерогенного чипа Intel, находящегося в массовом производстве, с более чем 100 миллиардами транзисторов, 47 активными плитками, 5 техпроцессами.
Таким образом, с точки зрения преимуществ, решение для передовой упаковки EMIB от Intel не только обеспечивает гибкость в размещении кристаллов, но и позволяет масштабироваться в обоих измерениях, что невозможно при использовании подхода 2.5D. Три ключевых преимущества, выделенных Intel для своей технологии EMIB:
- Обычные показатели выхода годных в корпусе
- Возможности экономии средств
- Простота проектирования
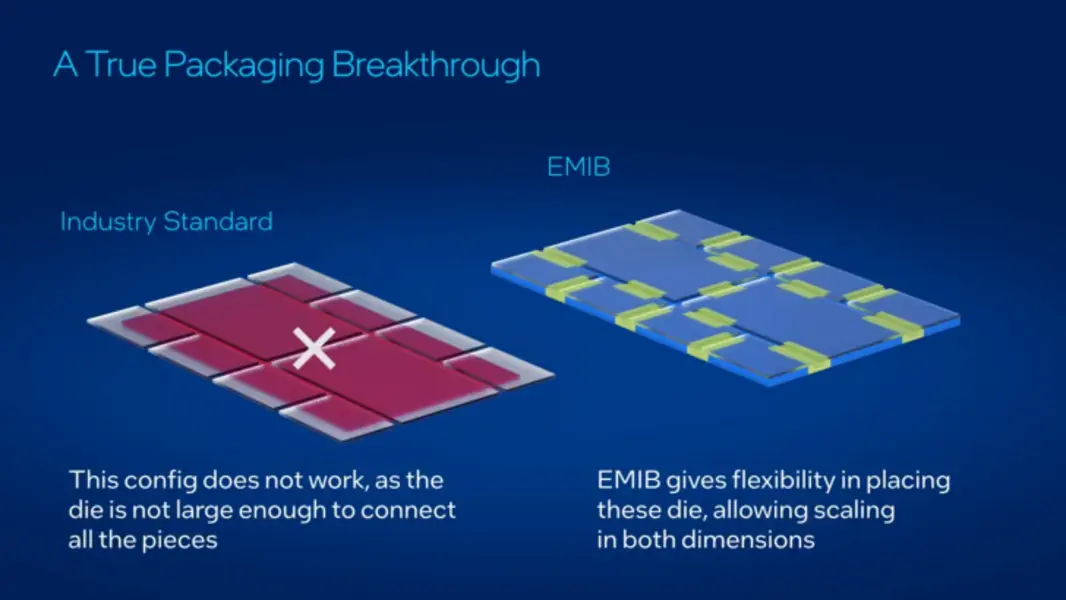
Поскольку Intel активнее развивает свой литейный бизнес и надеется привлечь больше внимания к будущим технологиям, таким как 14A, решения для передовой упаковки будут играть куда более важную роль. Усовершенствования EMIB, такие как вариант “T” и упаковка Foveros, уже привлекли внимание крупных игроков, что усиливает конкуренцию в сфере производства чипов, доминирующей до сих пор силами TSMC. Успех 14A критически важен для “Синей команды”, чтобы положить начало новой эре передового производства чипов прямо на территории США.
Всегда имейте в виду, что редакции могут придерживаться предвзятых взглядов в освещении новостей.
Автор – Hassan Mujtaba




